GB/T 26068-2018 硅片和硅錠載流子復(fù)合壽命的測(cè)試 非接觸微波反射光電導(dǎo)衰減法
實(shí)驗(yàn)室擁有眾多大型儀器及各類(lèi)分析檢測(cè)設(shè)備,研究所長(zhǎng)期與各大企業(yè)、高校和科研院所保持合作伙伴關(guān)系,始終以科學(xué)研究為首任,以客戶(hù)為中心,不斷提高自身綜合檢測(cè)能力和水平,致力于成為全國(guó)科學(xué)材料研發(fā)領(lǐng)域服務(wù)平臺(tái)。
立即咨詢(xún)網(wǎng)頁(yè)字號(hào):【大 中 小 】 | 【打印】 【關(guān)閉】 微信掃一掃分享:
注意:因業(yè)務(wù)調(diào)整,暫不接受個(gè)人委托測(cè)試望見(jiàn)諒。
聯(lián)系中化所
標(biāo)準(zhǔn)號(hào):GB/T 26068-2018
標(biāo)準(zhǔn)名稱(chēng):硅片和硅錠載流子復(fù)合壽命的測(cè)試 非接觸微波反射光電導(dǎo)衰減法
標(biāo)準(zhǔn)簡(jiǎn)介:本標(biāo)準(zhǔn)規(guī)定了單晶和鑄造多晶的硅片及硅錠的載流子復(fù)合壽命的非接觸微波反射光電導(dǎo)衰減測(cè)試方法。本標(biāo)準(zhǔn)適用于硅錠和經(jīng)過(guò)拋光處理的n型或p型硅片(當(dāng)硅片厚度大于1 mm時(shí),通常稱(chēng)為硅塊)載流子復(fù)合壽命的測(cè)試。在電導(dǎo)率檢測(cè)系統(tǒng)靈敏度足夠的條件下,本標(biāo)準(zhǔn)也可用于測(cè)試切割或經(jīng)過(guò)研磨、腐蝕的硅片的載流子復(fù)合壽命。通常,被測(cè)樣品的室溫電阻率下限在0.05 Ω·cm~10 Ω·cm之間,由檢測(cè)系統(tǒng)靈敏度的極限確定。載流子復(fù)合壽命的測(cè)試范圍為大于0.1 μs,可測(cè)的最短壽命值取決于光源的關(guān)斷特性及衰減信號(hào)測(cè)定器的采樣頻率,最長(zhǎng)可測(cè)值取決于樣品的幾何條件及其表面的鈍化程度。
英文名稱(chēng):Test method for carrier recombination lifetime in silicon wafers and silicon ingots—Non-contact measurement of photoconductivity decay by microwave reflectance method
標(biāo)準(zhǔn)狀態(tài):現(xiàn)行
發(fā)布日期:2018-12-28
實(shí)施日期:2019-11-01
出版語(yǔ)種:中文簡(jiǎn)體
標(biāo)準(zhǔn)ICS號(hào):77.040
中標(biāo)分類(lèi)號(hào):H21
提出部門(mén):全國(guó)半導(dǎo)體設(shè)備和材料標(biāo)準(zhǔn)化技術(shù)委員會(huì)(SAC/TC 203)、全國(guó)半導(dǎo)體設(shè)備和材料標(biāo)準(zhǔn)化技術(shù)委員會(huì)材料分會(huì)(SAC/TC 203/SC 2)
發(fā)布部門(mén):國(guó)家市場(chǎng)監(jiān)督管理總局、中國(guó)國(guó)家標(biāo)準(zhǔn)化管理委員會(huì)


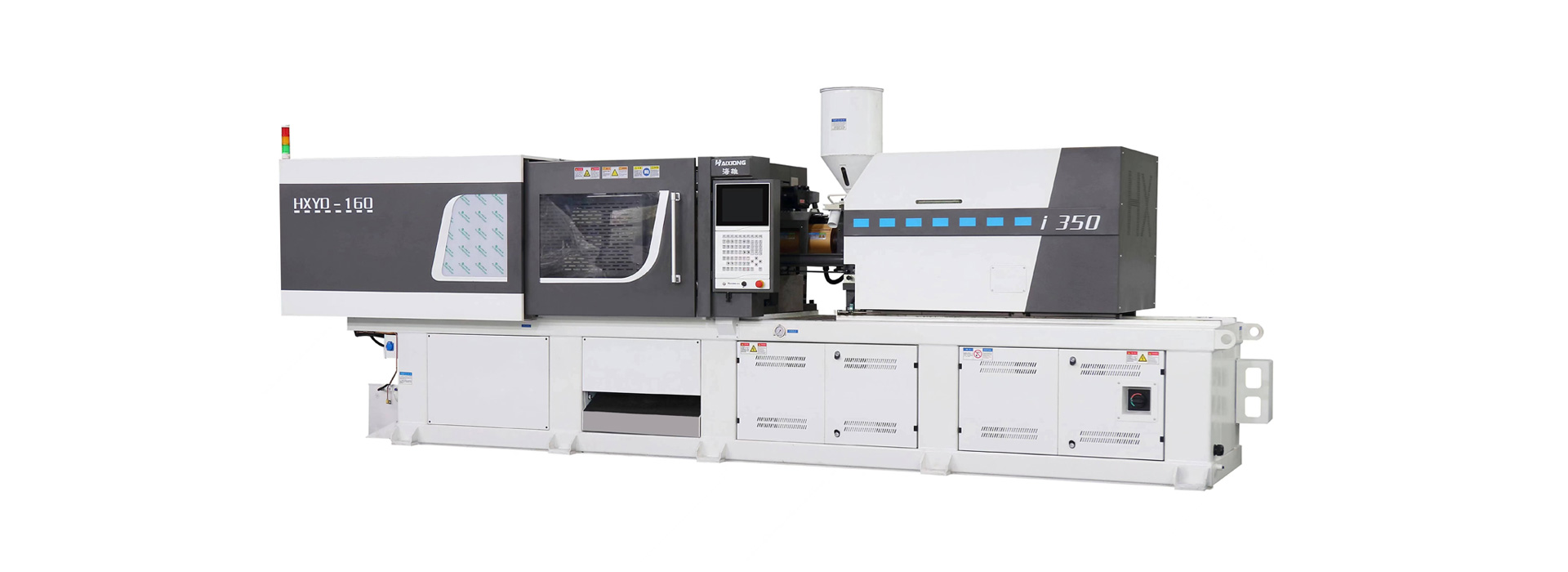


 掃一掃關(guān)注公眾號(hào)
掃一掃關(guān)注公眾號(hào)







